主に集積回路のパッケージング分野に使用されています。ウェーハレベルパッケージ(WLP)、パネルレベルパッケージ(PLP)、フリップチップ・ボールグリッドアレイ(FCBGA)、フリップチップ・チップスケールパッケージ(FCCSP)、システム・イン・パッケージ(SiP)などのパッケージ形態に対応し、チップアンダーフィル(Underfill)、ダム&フィル(Dam & Fill)、フラックススプレー(Flux Spray)、はんだペースト塗布(Solder Paste Painting)、ヒートスプレッダ貼付(Lid Attach)などのプロセスに用いられています。
パネルレベルパッケージ(PLP)
ウェーハレベルパッケージ(WLP)
フリップチップ・ボールグリッドアレイ(FCBGA)
フリップチップ・チップスケールパッケージ(FCCSP)
システム・イン・パッケージ(SiP)
チップアンダーフィル(Underfill)
ダム&フィル(Dam & Fill)
フラックススプレー(Flux Spray)
はんだペースト塗布(Solder Paste Painting)
ヒートスプレッダ貼付(Lid Attach)
インジウム貼付(Indium Attach)
リング貼付(Ring Attach)
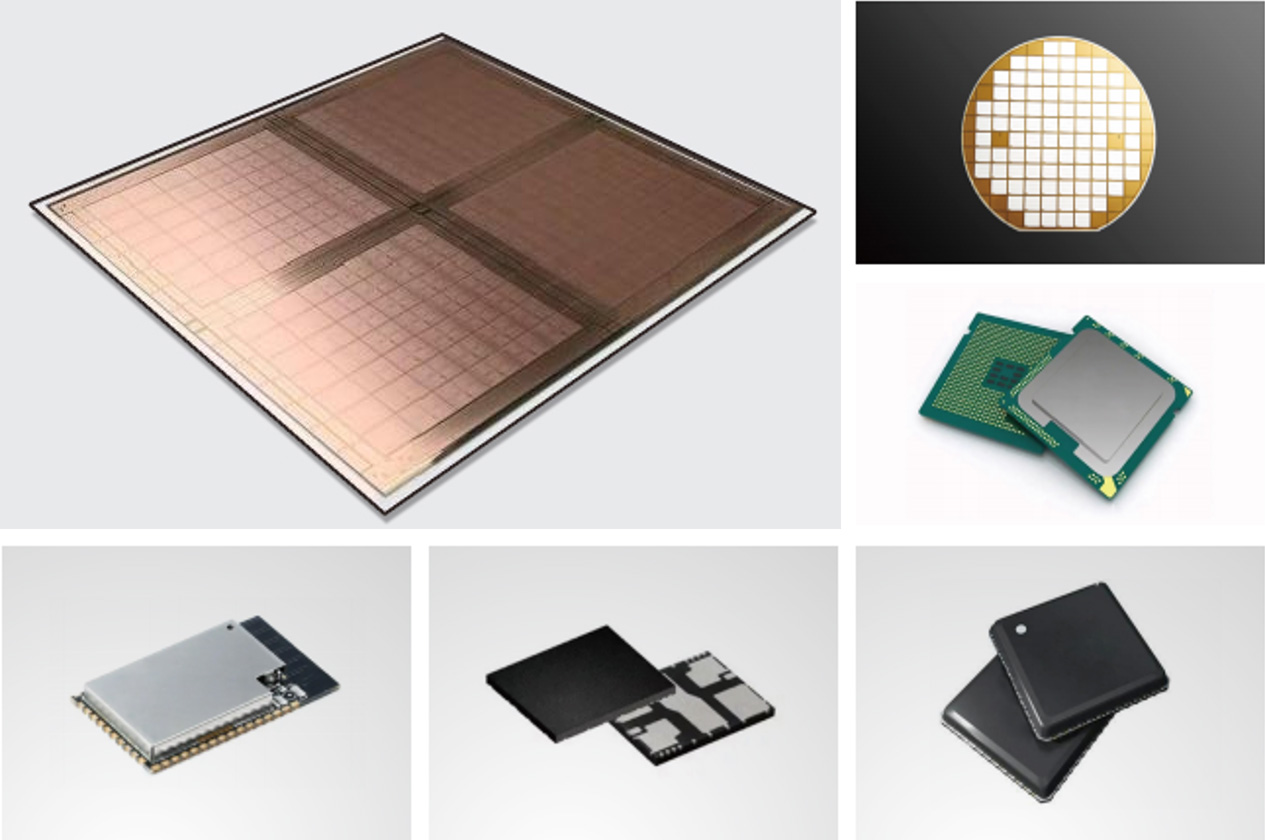
第3世代半導体である炭化ケイ素(SiC)は、高効率・小型化という特長を活かし、従来のシリコンデバイスの代替が加速しています。SiCは高硬度かつ高熱伝導率を有するため、従来の加工方法では精度と効率の両立が困難です。一方、水ジェット誘導レーザー加工技術は、非接触切断、高効率冷却、優れた表面品質、環境に配慮した加工特性や高い適応性といった特長を備えています。これにより、SiC材料を高精度に加工し、熱影響層の発生を抑え、材料変形や性能劣化を防止して、高性能デバイスの信頼性と安定性を高めます。
代表的な応用分野 |
代表的な加工材料 |
|---|---|
|
|
 カーボン基ダイヤモンド
カーボン基ダイヤモンド
 銅基ダイヤモンド
銅基ダイヤモンド
 窒化ホウ素
窒化ホウ素
 アルミナセラミックス
アルミナセラミックス